Process ChartKorea Circuit is at the center of the smart world.
层压 Lamination
用热与压力对电路的内层原材料与绝缘体进行层压的一道工序。
- 工序步骤 :

- 该工序对形成电路的内层基板与半固化片(Prepreg, P·P)、铜箔施加电压和热,令半固化片溶化/硬化,压合铜箔与内层基板, 制造出多层基板。
- Oxide(Brown)
- 氧化工序是为了增强绝缘体与铜箔的粘附力,在热压机(Hot press)工序过程中用化学方法处理内层基板的铜箔部分,在铜箔表面制造粗糙度(roughness, 氧化镀层)。
- 第一次叠合(绑定)
- 第二次叠合准备工序是把形成内层电路的Core与Prepreg与板层位置对齐, 叠合产品。Bonding(绑定)方式是最普遍广泛被使用的方式。
- 第二次叠合
- 为了Press而进行的一道准备工序,将各种治具与第一次叠合过的产品和铜箔组合起来,反复叠合。
- Hot Press
- 加压加热溶化、硬化Prepreg,令铜箔和内层Core粘附,制造多层基本。
- 图片

- 产品图片

工序图片(代表设备)
-

Oxide
-

1st lay up
-
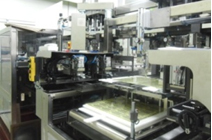
2nd Lay-up
-

Hot press